先进 IC 技术
AI、5G、云和边缘计算、自动驾驶汽车、移动设备。当今的电子产品和未来的技术都需要先进的GPU、CPU、DRAM和3D NAND芯片。这些IC使用复杂的形状和新材料制造,具有更小、更窄、更高和更深的结构。这种结构的复杂性要求控制图案的偏差异常,确保制造成功。
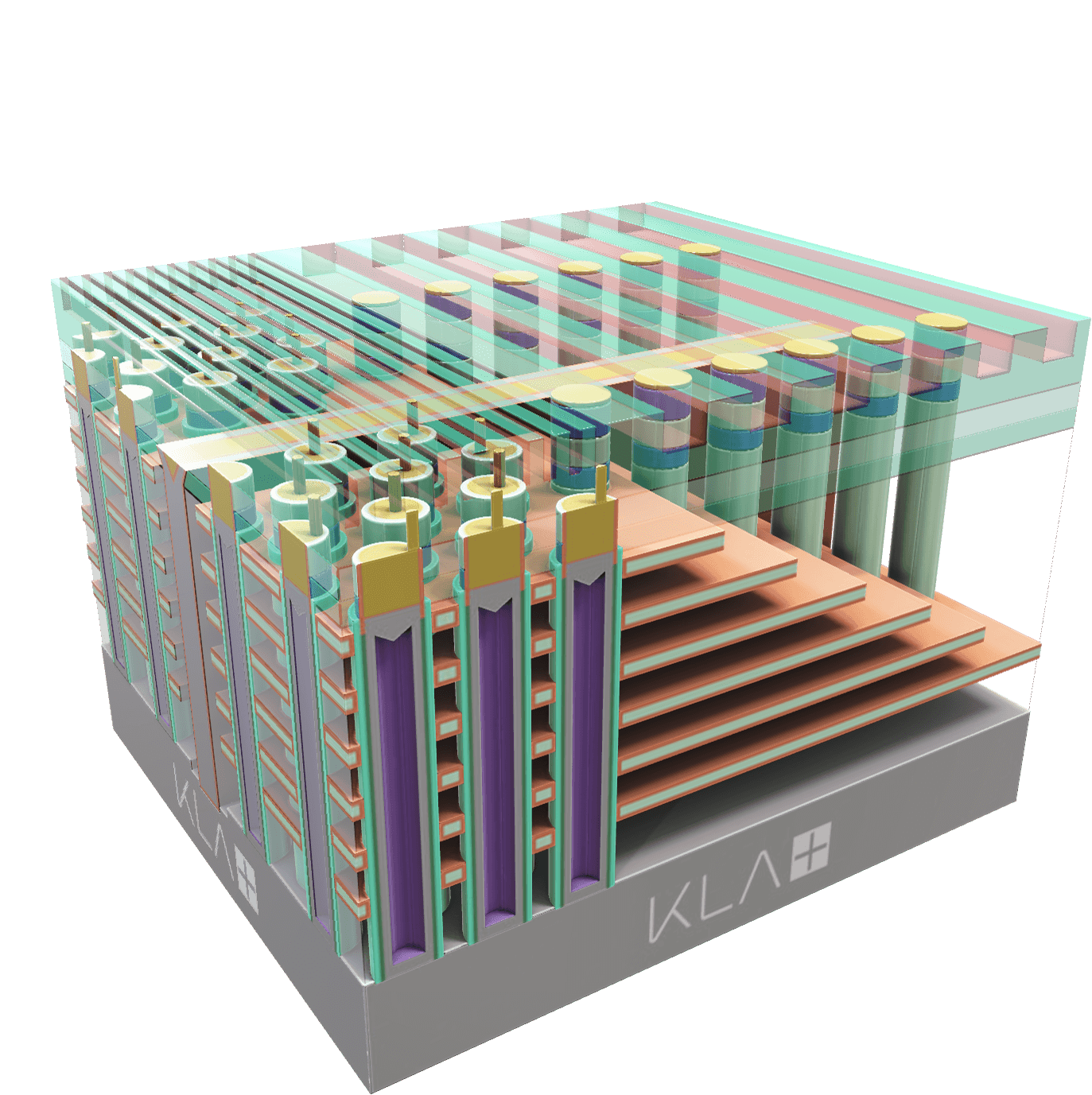
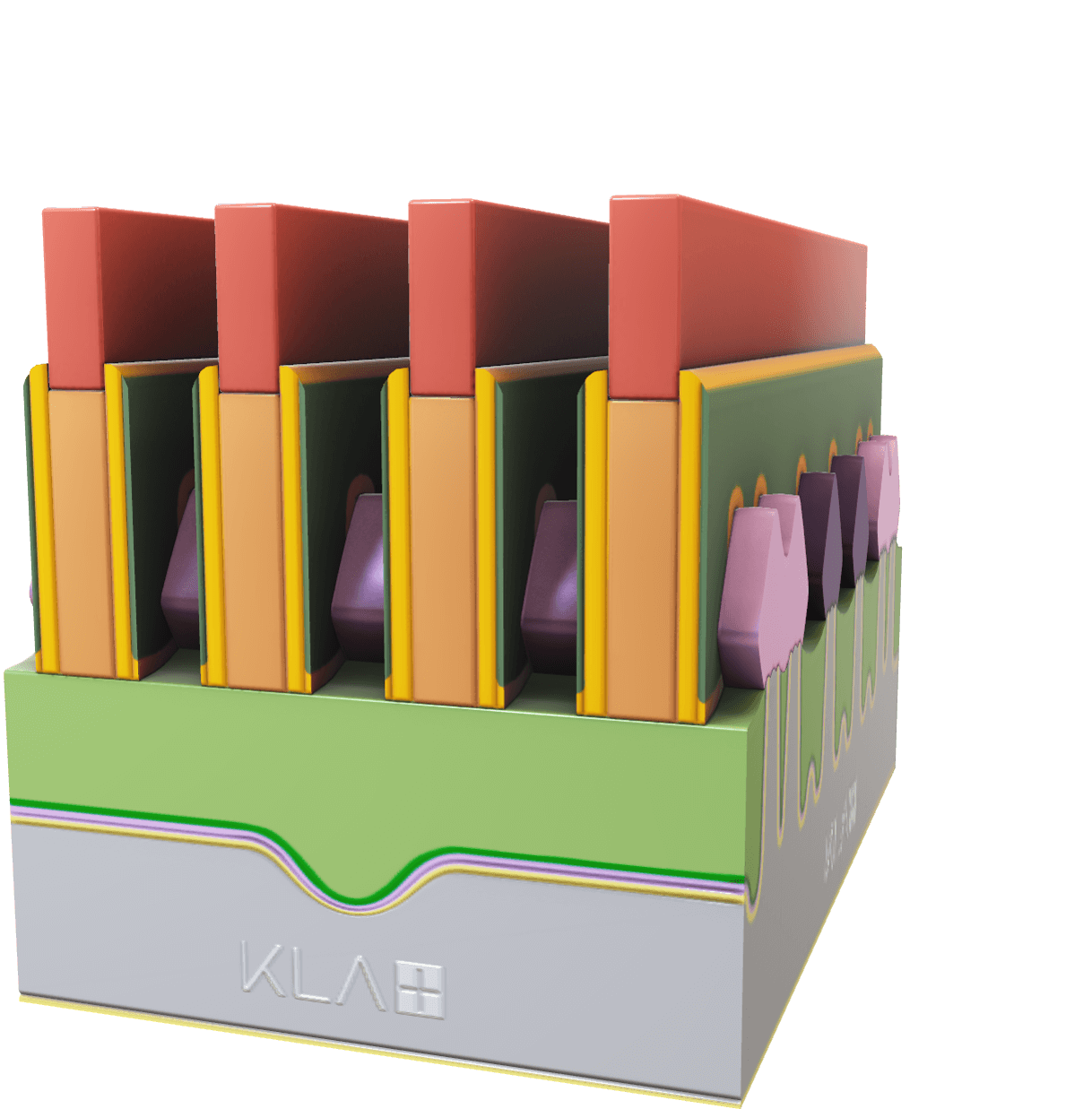
产品组合
我们的量测解决方案可精确测量图案尺寸、膜厚、层间对准、图案位置、表面形貌、晶圆几何形状和实时制程。这种创新的系统产品组合可帮助芯片制造商保持对包括EUV光刻在内的整个晶圆厂制程的严格控制,以提高逻辑、DRAM和3D NAND器件的性能。
加入该家族的还有Archer™750和SpectraShape™11k!凭借多种光学和平台创新技术及先进的机器学习算法,这些全新系统促进了关键图案参数的测量和控制,从而帮助IC工程师实现出色的图案规格控制。

点击进入互动体验
Archer™ 750
全新基于成像技术的新型套刻量测系统可准确快速地测量套刻误差帮助光刻工程师识别在线偏移并提高图案形成性能。
- 具有10nm分辨率的独特波长可调性,可在制程变化的情况下提供准确而强大的套刻误差测量,以实现快速的技术升级并稳定生产高级逻辑和存储器件
- 新的CPL(每层颜色)测量模式增强了目标信噪比,可在具有挑战性的光刻堆栈、EUV光刻胶以及不透明膜上进行精确的套刻测量
- 硬件的改进,包括新的工作台和传感器,将系统的生产率提高到只有基于散射测量的套刻系统才能实现的水平,提高了套刻采样率,支持光刻机高阶校正和大批量生产
- 先进的新算法和新颖的rAIM®套刻目标设计改进了器件与目标的相关性,提供更好的制程稳定性,从而改善对器件套刻性能的跟踪

点击进入互动体验
SpectraShape™ 11k
最新的CD和尺寸形状量测系统可对关键器件特征进行高精度,高采样测量,监控先进的IC制程。
- 光源、偏振、平台和其他子系统的重大技术改进支持以高灵敏度和高产能测量关键设备的特征,从而快速确定批量生产中的制程问题
- 与上一代SpectraShape系统相比,快速多角度(FMA)能够以高信号强度从多个照明角度同时收集数据,以更高的灵敏度和速度测量具有挑战性的制程层参数
- 扩展的红外波长范围、高分辨率反射仪和可容纳高弓形晶圆的新型卡盘,可用于测量厚硬掩模和厚膜堆叠参数,例如高纵宽比导通孔蚀刻的CD、高度和凹槽,以监控并控制高级DRAM 和3D NAND制程
- TurboShape™算法有助于在光刻ADI层进行CD和形状的测量,实现对新光刻机控制或蚀刻制程控制策略,从而提高图案形成性能


